台阶仪/椭偏仪在不同半导体关键工序中的计量技术与应用
随着半导体技术向高集成度与高性能方向不断发展,工艺尺寸持续缩小,制造工艺对膜厚、线宽、台阶高度及电阻率等关键参数的测量精度提出了更高要求。然而,半导体测量设备在实际应用中面临量值溯源体系不完善、测量结果不一致等突出问题,直接影响工艺控制的准确性与器件性能的可靠性。Flexfilm探针式台阶仪可以实现表面微观特征的精准表征与关键参数的定量测量,精确测定样品的表面台阶高度与膜厚,为材料质量把控和生产效率提升提供数据支撑。
本文通过系统研究台阶仪、椭偏仪、扫描电子显微镜和四探针测试仪等典型测量设备的计量方法,分析其量值溯源中的关键要素,提出构建多维度计量数据模型库,并建立基于数据的设备管控决策机制,从而为实现测量设备的精准溯源、科学管理与全生命周期控制提供有效解决方案,推动工艺质量提升与良率优化。
1
测量设备与工艺对应关系
flexfilm

典型测量设备与对应工艺
半导体工艺流程复杂,涵盖晶圆制备、沟槽光刻、沟槽刻蚀、薄膜沉积、离子注入、抛光、金属化及封装测试等环节。每道工序均需配备专用测量设备,以监控关键参数。
2
典型设备计量技术
flexfilm
台阶仪
(a)台阶仪测量原理(b)台阶高度样板(c)台阶高度样板三维图像(d)台阶仪校准数据
台阶仪为接触式表面形貌测量设备,通过探针在样品表面移动,感知高度变化,转换为电信号并重建轮廓。其校准依赖于台阶高度标准样板,该样板经光刻、刻蚀、溅射等工艺制成,具备已知高度与良好表面特性。
校准过程中,采用激光干涉仪或原子力显微镜对台阶高度进行定值,依据JJF129—2017规范评价仪器的示值误差与重复性。
椭偏仪
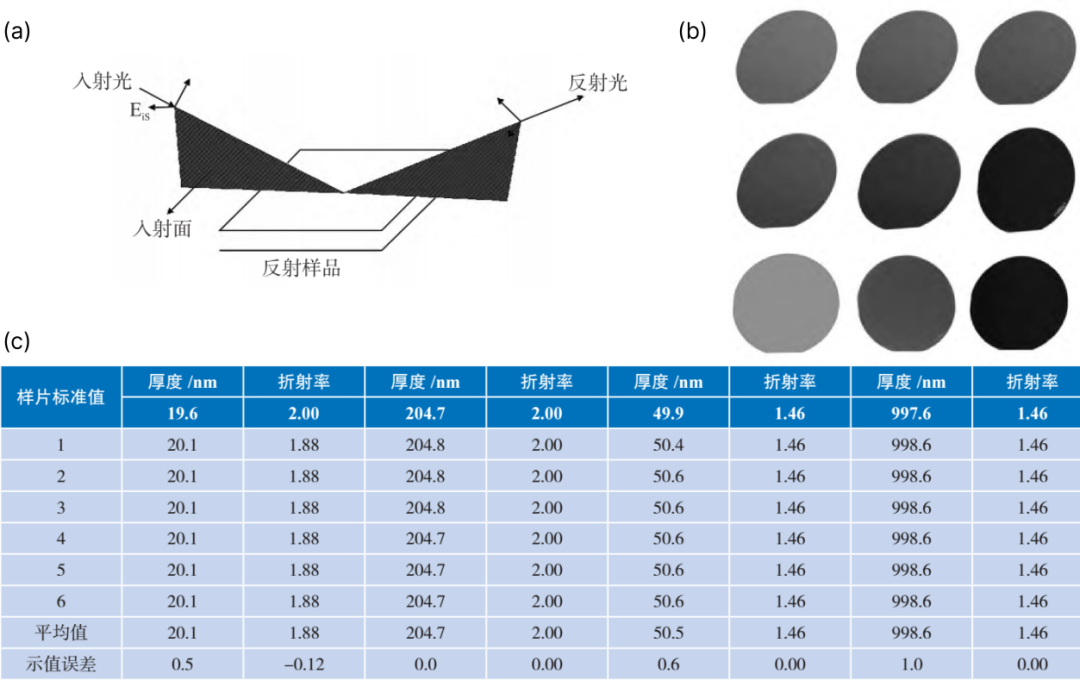
(a)椭偏仪测量原理(b)研制的 2~1 000 nm 膜厚标准样片(c)椭偏仪校准数据
椭偏仪通过分析偏振光在薄膜表面的反射行为,获取薄膜厚度与折射率。其校准采用氧化法制备的膜厚标准样板,定值设备包括XPS与光谱型椭圆仪。
校准依据JJG14—2011,重点评估膜厚与折射率的测量准确度。
扫描电子显微镜(SEM)
(a)线距样板:左-竖栅,右-格栅(b)X 向测量示值误差
SEM通过电子束扫描样品表面,收集二次电子等信号成像,用于微纳尺度图形测量。其校准采用线距标准样板,通过原子力显微镜或可溯源SEM进行定值。
校准依据JJF 1351—2012,评估测长示值误差、正交畸变等参数。
四探针测试仪
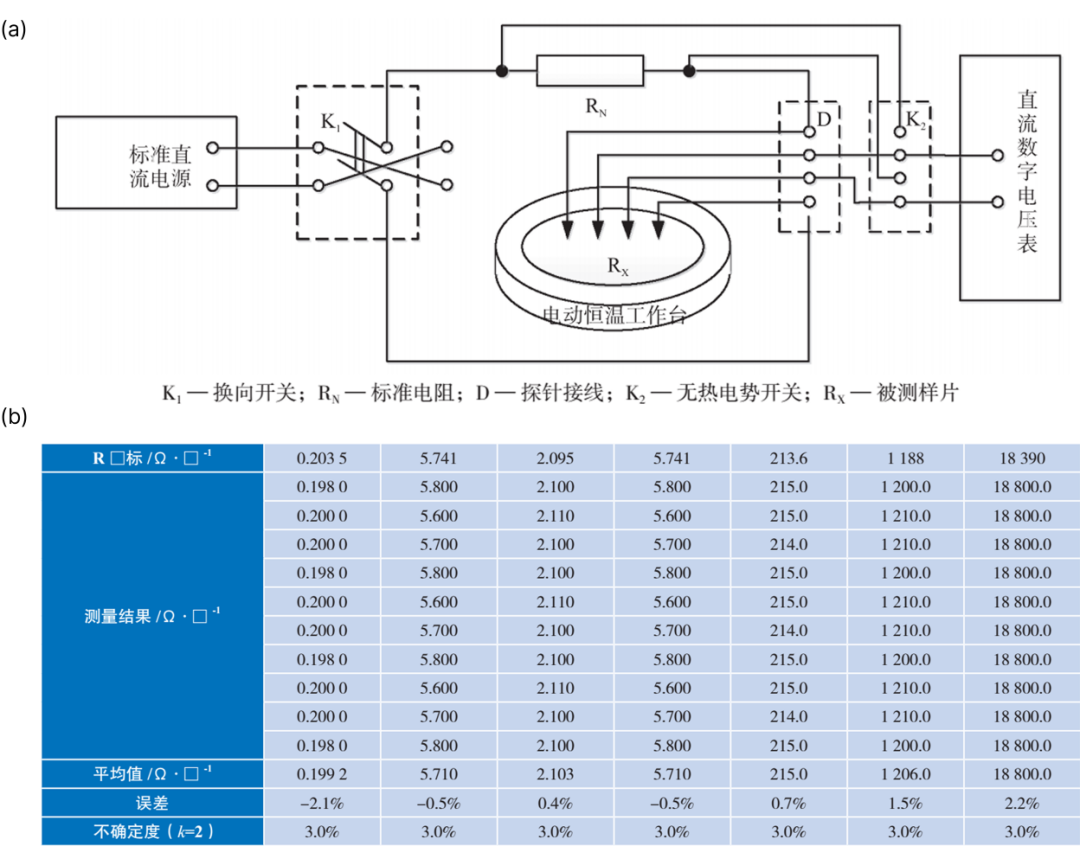
(a)四探针测试仪测量原理(b)方阻示值误差
四探针测试仪采用直流四探针法测量电阻率,通过外侧探针注入电流,内侧探针检测电压,计算得出电阻率值。校准采用掺杂硅片作为电阻率标准样板,通过标准电流源与纳伏表实现溯源。校准依据JG 508—2004,主要评价方阻示值误差,典型误差控制在3%以内。
3
计量管控决策机制
flexfilm
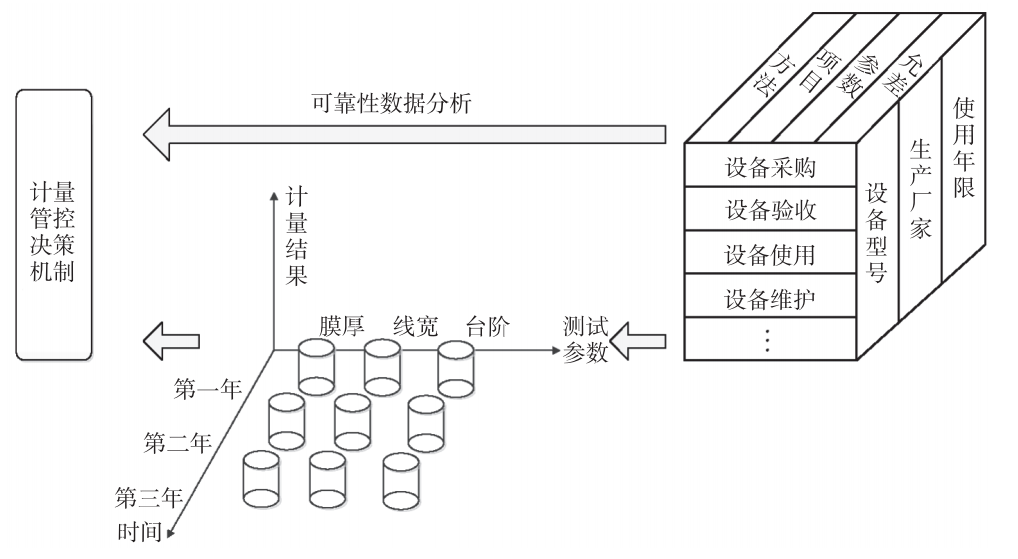
基于数据的计量技术管控体系决策机制思路
为实现设备全生命周期管理,提出基于数据的计量技术管控体系。该体系通过采集多维度计量数据与设备运行状态信息,构建计量数据模型库,集成至质量管理平台。系统能够自动评估设备重复性、稳定性,识别关键参数,制定科学校准周期与应急响应机制,为设备采购、验收、使用与维护提供决策支持。
半导体测量设备的准确性与可靠性直接关系到工艺控制水平与产品良率。本文系统阐述了台阶仪、椭偏仪、SEM与四探针测试仪等典型设备的计量方法与溯源体系,并提出构建数据驱动的计量管控机制,为半导体制造企业提升工艺控制能力与设备管理水平提供技术参考。未来,随着工艺节点不断推进,计量技术将继续朝着更高精度、更强溯源性与更智能化的方向发展。
Flexfilm探针式台阶仪
flexfilm

在半导体、光伏、LED、MEMS器件、材料等领域,表面台阶高度、膜厚的准确测量具有十分重要的价值,尤其是台阶高度是一个重要的参数,对各种薄膜台阶参数的精确、快速测定和控制,是保证材料质量、提高生产效率的重要手段。
- 配备500W像素高分辨率彩色摄像机
- 亚埃级分辨率,台阶高度重复性1nm
- 360°旋转θ平台结合Z轴升降平台
- 超微力恒力传感器保证无接触损伤精准测量
费曼仪器作为国内领先的薄膜厚度测量技术解决方案提供商,Flexfilm探针式台阶仪可以对薄膜表面台阶高度、膜厚进行准确测量,保证材料质量、提高生产效率。
原文参考:《典型半导体工艺测量设备计量技术》
*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
- 随机文章
- 热门文章
- 热评文章
- 多国驻华大使、“Z世代”青年直播赋能南博会,多国驻华大使、“Z世代”青年直播赋能南博会
- 通话录音遭泄露后被要求下台 泰国总理佩通坦致歉,通话录音遭泄露后被要求下台 泰国总理佩通坦致歉
- 第七届黑龙江省旅游产业发展大会将在“华夏东极”抚远启幕,第七届黑龙江省旅游产业发展大会将在“华夏东极”抚远启幕
- “中国伞都”福建晋江启用“全球伞业供应链中心”,“中国伞都”福建晋江启用“全球伞业供应链中心”
- 暴雨致广东怀集变“泽国” 多方力量展开救援,暴雨致广东怀集变“泽国” 多方力量展开救援
- 6月18日人民币对美元中间价报7.1761元 下调15个基点,6月18日人民币对美元中间价报7.1761元 下调15个基点
- (进博故事)“进博宝宝”跑出审批“加速度”,(进博故事)“进博宝宝”跑出审批“加速度”
- “遇见三峡文化”活动启幕 共话中华和合智慧,“遇见三峡文化”活动启幕 共话中华和合智慧
- 深圳构建民企涉外法律服务体系 赋能民企出海,深圳构建民企涉外法律服务体系 赋能民企出海
- 广西涉海部门推动“联建联动联管联治”合作,广西涉海部门推动“联建联动联管联治”合作
- 祁连山下肃南康乐草原牧民有了“新身份”,祁连山下肃南康乐草原牧民有了“新身份”
- (乡村行·看振兴)山西柳林:鲈鱼陆基养殖“新招” 乡村增收致富“提速”,(乡村行·看振兴)山西柳林:鲈鱼陆基养殖“新招” 乡村增收致富“提速”
- 锡林郭勒草原上的牧民驯马人,锡林郭勒草原上的牧民驯马人
- 1电源测试系统:高压性能二合一,高效测试新选择
- 2“刻骨铭心——甲骨文化展”在广西桂林开幕,“刻骨铭心——甲骨文化展”在广西桂林开幕
- 3中国首创 “蒸笼” 法,蒸出高性能 “黄金半导体”
- 4AI产业链掘金潮蔓延:OCS概念股爆发 这些“头号玩家”已率先进场
- 5(寻味中华|非遗)蒙古族搏克:摔跤之力在腰,决胜之智在心,(寻味中华|非遗)蒙古族搏克:摔跤之力在腰,决胜之智在心
- 6海默科技(300084):披露权益变动报告书的提示性公告
- 7结题材料不合格,只因订书钉没用不锈钢?
- 8汇隆活塞(833455):第四届监事会第七次会议决议
- 9钓鱼打窝船总掉链?仁懋 TOLL 封装 “芯” 方案
- 10居然智家迎来新实控人:汪林朋配偶杨芳继承43.93%公司股权 其余法定继承人自愿放弃
- 11来了!广西首批高考录取通知书送达→
- 12赣州市章贡区市场监管局开展“你送我检”进市场服务惠民生暨整治制售假劣肉制品宣传活动
- 13声桥—中欧艺术交流音乐会在德国法兰克福举行,声桥—中欧艺术交流音乐会在德国法兰克福举行
- 12025年廊坊经洽会:小箱包“圈粉”大咖 县域特色产业快速出海,2025年廊坊经洽会:小箱包“圈粉”大咖 县域特色产业快速出海
- 2宇树科技完成C轮融资 注册资本增至3.64亿,宇树科技完成C轮融资 注册资本增至3.64亿
- 3第六届西部数博会文旅“黑科技”破壁虚实,第六届西部数博会文旅“黑科技”破壁虚实
- 4四川乐山:餐饮行业大咖齐聚共绘美食产业新蓝图,四川乐山:餐饮行业大咖齐聚共绘美食产业新蓝图
- 5黑龙江省水运口岸首次进口铜矿粉 “铁水联运”激活跨境物流新引擎,黑龙江省水运口岸首次进口铜矿粉 “铁水联运”激活跨境物流新引擎
- 6全球乳业大会开幕!伊利作为亚洲乳企代表受邀出席,斩获世界乳品创新奖,全球乳业大会开幕!伊利作为亚洲乳企代表受邀出席,斩获世界乳品创新奖
- 7河南粮食重点领域贷款余额超2595亿元,河南粮食重点领域贷款余额超2595亿元
- 8廊坊经洽会观察:跨境电商如何赋能产业出海?,廊坊经洽会观察:跨境电商如何赋能产业出海?
- 92025夏季达沃斯实现全绿色用能 减排二氧化碳约600吨,2025夏季达沃斯实现全绿色用能 减排二氧化碳约600吨
- 10上合组织国家留学生探访山东青岛体验“智造”魅力,上合组织国家留学生探访山东青岛体验“智造”魅力
- 11浙江加速城乡融合高质量发展步伐,浙江加速城乡融合高质量发展步伐
- 12合肥推动“车机人”协同计划 打造聚合型智能产业集群,合肥推动“车机人”协同计划 打造聚合型智能产业集群
- 13(活力中国调研行)百年高炉遇见未来 北京科幻产业加速跑,(活力中国调研行)百年高炉遇见未来 北京科幻产业加速跑




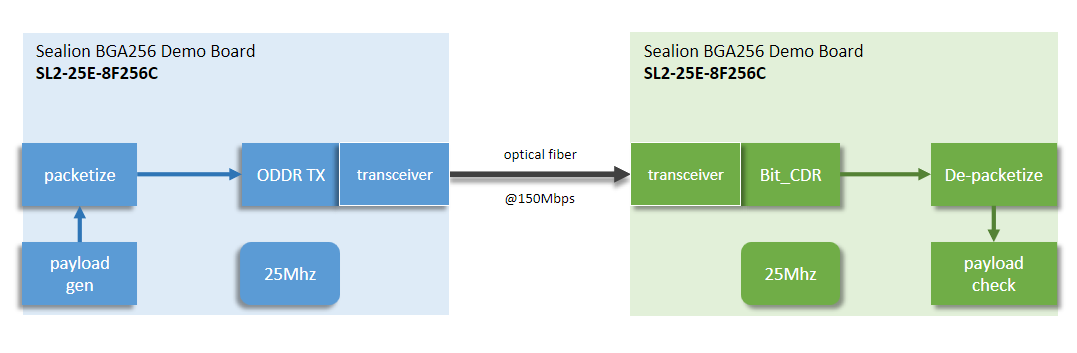




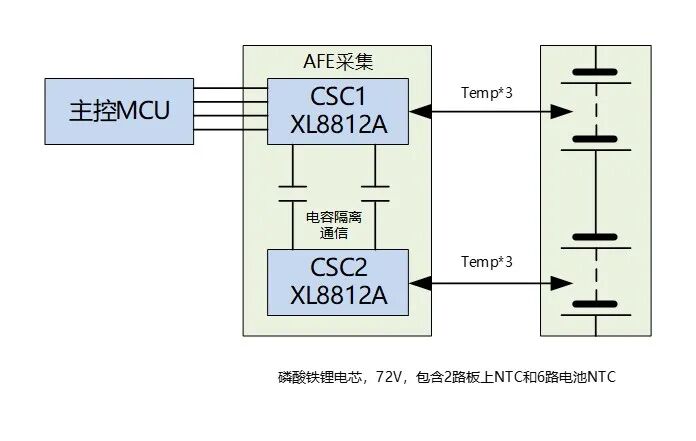



![[快讯]恒星科技公布2024年年度分红实施方案](http://www.lelefa.com/zb_users/theme/ydlanbai/include/random/103.jpg)






